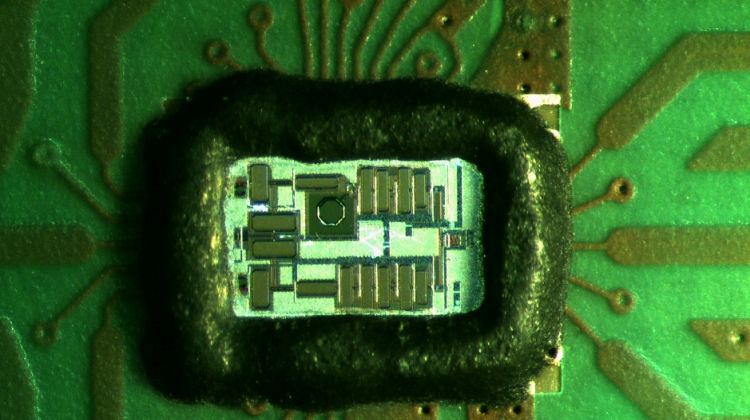
(foto: CEA-Leti)
På ECTC (Electronic Components and Technology Conference) konferencen i Orlando, Florida 26.-29. maj, 2026 præsenterer franske CEA-Leti syv indlæg og postere om den teknologi, der vil skabe næste generation af avanceret heterogen integration. Denne forskning omfatter en række teknologier inklusive reducering af interkonnekt afstande (pitches) gennem hybride bonding forbindelser, halvlederprocesser ved lav temperatur, superledende interkonnekt og fan-out pakning på wafer-niveau. Hybrid bonding er baseret på direkte kobber-til-kobber og dielektrisk-til-dielektrisk forbindelsesteknologi, som muliggør ultra fine vertikale forbindelser. Denne teknologi vil blive den primære til 3D integration med stor tæthed i takt med, at micro-bump metoden nærmer sig grænsen for skalerbarhed. For eksempel vil Leti præsentere sin første testplatform for die-til-wafer hybrid bonding med en pitch ned til 1 µm.
Foruden fundamental procesudvikling vil Leti’s forskere også præsentere fremskridt inden for applikationsspecifik integration, herunder superledende 3D interkonnekt infrastruktur til kvante-computere, samt radar system-in-package med integrerede antenner til mm-wave applikationer såsom 5G/6G og automotiv radar.
Titlerne på indlægge og posterne er:
- “Hybrid Bonding with Ultra-Low Temperature Annealing: Morphological and Electrical Validations”
- “Enabling Low-Temperature Fine-Pitch Hybrid Bonding: Role of Nanocrystalline Copper Microstructures and Pre-Bond Surface Treatments”
- “RADAR System-in-Package with Integrated Antennas based on Fan-Out Wafer-Level Packaging RDL-First”
- “Electroplated Indium Micro-Bumps: Toward Scalable Low Temperature Ultra-Fine Pitch Interconnects”
- “Impact of Copper Density on Via-to-Via Hybrid Bonding: Morphological and Electrical Characterizations”
- “Fine-Pitch Thermally Resistive Superconducting 3D Interconnects for Quantum Systems”
- “Die-To-Wafer Hybrid Bonding Technology down to 1 μm pitch for Multi-Die Stacking Integration”
JSL

